中國科學院官網刊文稱,上海光機所在計算光刻技術研究方面取得重要進展。
近日,中科院上海光學精密機械研究所信息光學與光電技術實驗室提出一種基於虛擬邊(Virtual Edge)與雙采樣率像素化掩模圖形(Mask pixelation with two-phase sampling)的快速光學鄰近效應修正技術(Optical proximity correction, OPC)。仿真結果表明,該技術具有較高的修正效率。
光刻是極大規模集成電路製造的關鍵技術之一,光刻解析度決定集成電路的特徵尺寸。隨著集成電路圖形的特徵尺寸不斷減小,光刻系統的衍射受限屬性導致明顯的光學鄰近效應,降低了光刻成像質量。
在光刻機軟硬體不變的情況下,採用數學模型和軟體算法對照明模式、掩模圖形與工藝參數等進行優化,可有效提高光刻解析度、增大工藝窗口,此類技術即計算光刻技術(Computational Lithography),被認為是推動集成電路晶片按照摩爾定律繼續發展的新動力。
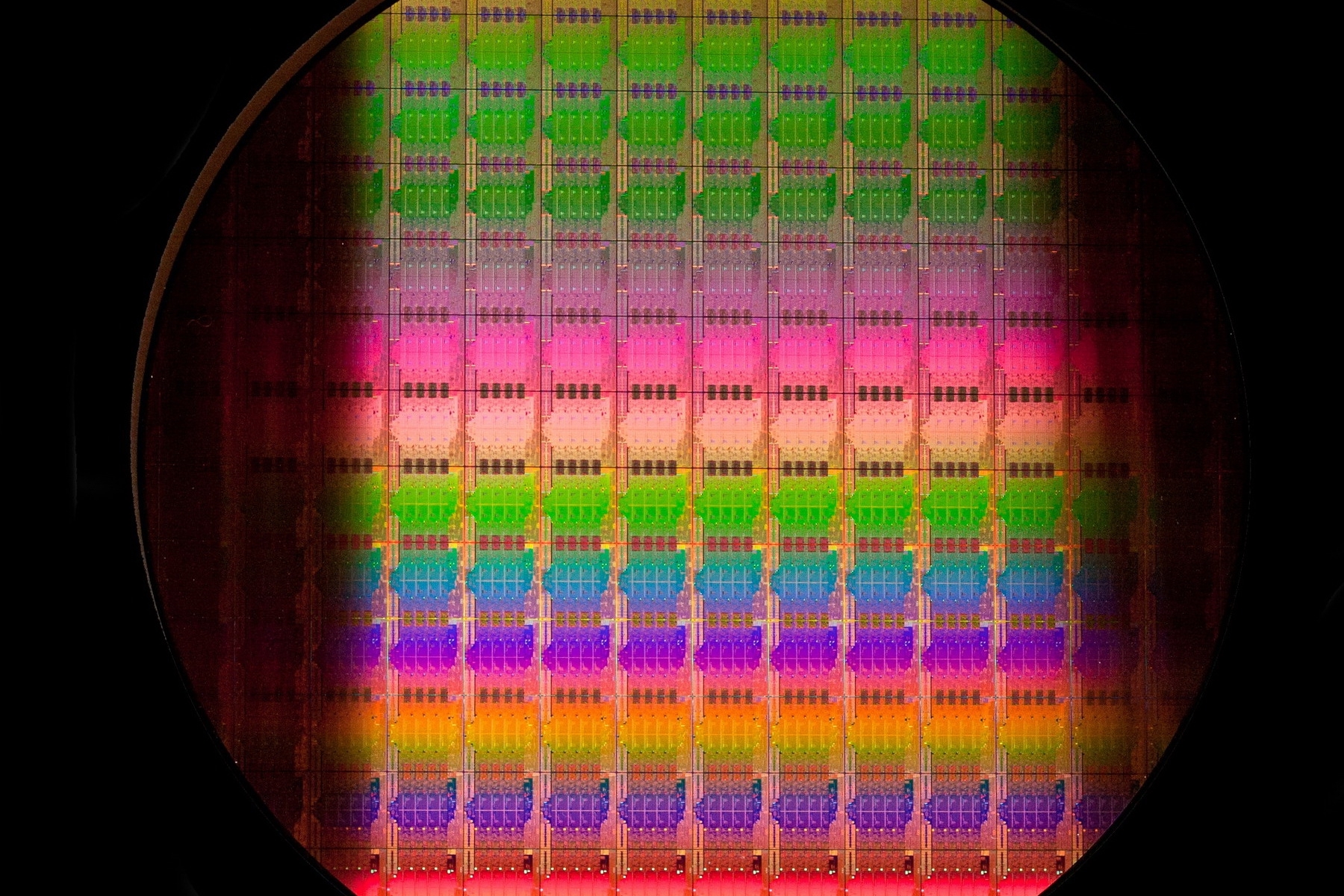
OPC技術通過調整掩模圖形的透過率分布修正光學鄰近效應,從而提高成像質量。基於模型的OPC技術是實現90nm及以下技術節點集成電路製造的關鍵計算光刻技術之一。
上海光機所科研人員提出的這種基於虛擬邊、雙采樣率像素化掩模圖形的快速光學鄰近效應修正技術,能夠將不同類型的成像失真歸結為兩種類型的成像異常,即內縮異常與外擴異常。
利用不同的成像異常檢測模板,依次在掩模圖形的邊緣和拐角等輪廓偏移判斷位置進行局部成像異常檢測,確定異常類型及異常區域的范圍。
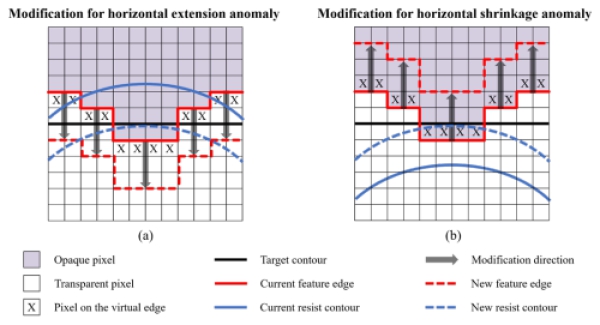
根據異常檢測位置與異常區域范圍,自適應產生虛擬邊。通過移動虛擬邊調整掩模的局部透過率分布,從而修正局部成像異常。藉助修正策略和修正約束,實現高效的局部修正和全局輪廓保真度控制。
另外,雙采樣率像素化掩模充分利用了成像系統的衍射受限屬性,在粗采樣網格上進行成像計算與異常檢測,在精采樣網格上進行掩模修正,兼顧了成像計算效率與掩模修正解析度。
利用多種掩模圖形進行驗證,仿真結果表明該OPC技術的修正效率優於常用的基於啟發式算法的OPC技術。
相關研究成果已經發表在Optics Express上。
來源:遊民星空








