SK海力士宣布,已經與Xperi Corp旗下子公司Invensas簽訂新的專利與技術授權協議,獲得了後者DBI Ultra 2.5D/3D互連技術的授權。
DBI Ultra是一種專利的裸片-晶圓(die-wafer)混合鍵合互連技術,每平方毫米的面積里可以容納10萬個到100萬個互連開孔,孔間距最小隻有1微米,相比每平方毫米最多625個互連開孔的傳統銅柱互連技術,可大大提高傳輸帶寬。
DBIUltra使用化學鍵合來連接不同的互聯層,也不需要銅柱和底層填充,因此不會增加高度,從而大大降低整體堆疊高度,釋放空間,可將8層堆疊翻番到16層堆疊,獲得更大容量。
雖然它要使用新的工藝流程,但是良品率更高,也不需要高溫,而高溫正是影響良品率的關鍵因素。

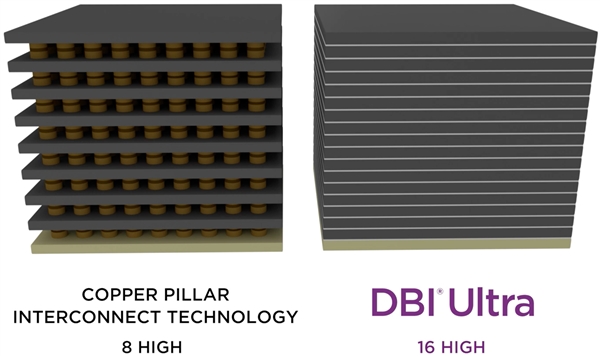
和其他下一代互連技術類似,DBI Ultra也靈活支持2.5D、3D整合封裝,還能集成不同尺寸、不同工藝製程的IP模塊,因此不但可用來製造DRAM、3DS、HBM等記憶體芯片,也可用於高集成度的CPU、GPU、ASIC、FPGA、SoC。
比如3D堆棧記憶體方案,可以是4層的DRAM,可以是4/8/12/16層的HBM2/HBM3並在底部整合邏輯電路。
比如3D集成方案,可以上方是4-16層堆疊HBM、下方是CPU/GPU/FPGA/SoC等邏輯單元。
比如2.5D集成方案,可以在基板上一邊是4-16層堆疊HBM並通過邏輯電路接入基板,另一邊則是CPU/GPU/FPGA/SoC等邏輯單元直接以DBI Ultra互連的方式接入基板。

SK海力士還未透露會將DBI Ultra封裝技術用在哪里,但是DRAM、HBM顯然是最佳選擇。
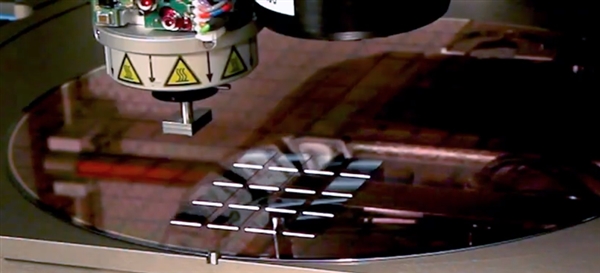

來源:快科技








