在Intel、台積電各自推出自家的3D芯片封裝技術之後,三星也宣布新一代3D芯片技術——X-Cube,基於TSV硅穿孔技術,可以將不同芯片搭積木一樣堆疊起來,目前已經可以用於7nm及5nm工藝。
關於3D芯片封裝,了解半導體芯片技術的玩家應該不陌生了,現有的芯片都是2D平面堆疊的,隨着芯片數量的增多,占用的面積越來越大,不利於提高集成度。
3D封裝顧名思義,就是將芯片從平面堆疊變成了垂直堆疊,類似搭積木那樣一層層疊加,減少了芯片面積,提高了集成度。
台積電、Intel之前都公布了3D封裝技術,技術風向大同小異,具體的實現方法不同,,已經在Lakefield芯片上應用,集成了10nm CPU、22nm IO核心。
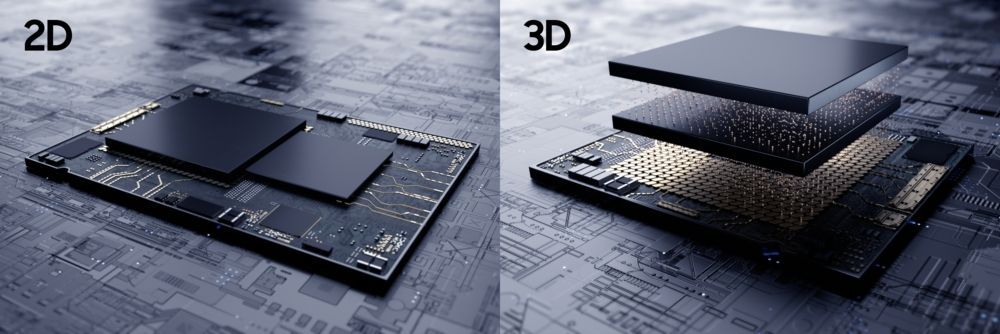
三星自家的3D封裝技術叫做X-Cube,基於TSV硅穿孔技術將不同芯片堆疊,已經可以將SRAM芯片堆疊到芯片上方,釋放了占用空間,可以堆棧更多記憶體芯片。
此外,TSV技術還可以大幅縮短芯片之間的信號距離,提高了數據傳輸速度,降低了功耗,並且客戶還可以按需定製記憶體帶寬及密度。
目前三星的X-Cube技術已經可以用於7nm及5nm工藝,三星將繼續與全球無經驗半導體公司合作,將該技術部署在新一代高性能芯片中。



來源:快科技









